2026开工首篇:迈向更高功率密度,从读懂 TIM1与TIM1.5开始
在人工智能、数据中心、高性能计算和汽车功率电子等高性能应用领域中,随着设备不断突破性能极限,热管理成为一项关键挑战。传统聚合物基热界面材料性能已逐渐难以满足严苛的散热需求。金属导热界面材料因能实现卓越导热性能,成为当前的首选解决方案。为电子设备进一步微型化、提升系统可靠性与长期稳定运行提供了坚实保障。
在先进封装中,TIM1和TIM1.5是两个基础且关键的热界面层。TIM1应用于芯片层级,作为芯片和散热盖之间的界面材料;而TIM1.5是裸芯片和散热器之间。要释放下一代器件的全部性能潜力,必须理解二者的特性及其带来的具体挑战。接下来,我们将重点剖析它们的区别、背后的技术驱动因素,以及在先进封装中的应用实践。
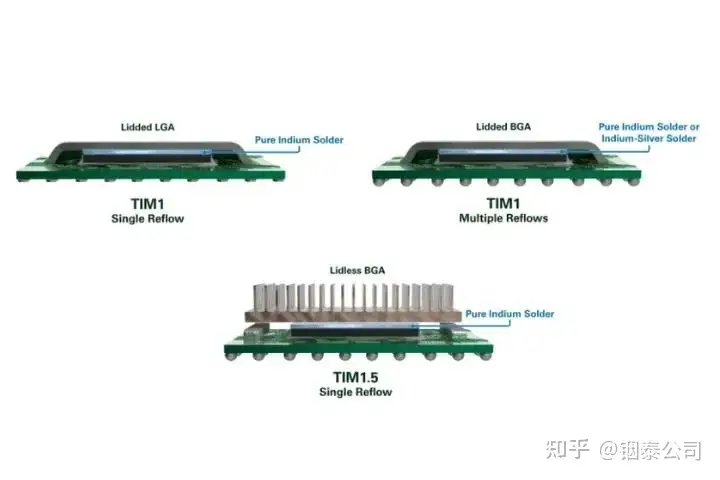
TIM1与TIM1.5应用场景
在高功率密度组件中,TIM1和TIM1.5应用中最常用的金属是纯铟和铟基合金。这类材料凭借其卓越的导热性能、低热阻以及优异的长期可靠性,能与大面积、易翘曲的表面形成牢固的机械结合。针对这两种应用,采用焊接型导热界面材料均需在硅芯片背面以及散热盖或散热器焊接面进行金属化处理。
TIM1
TIM1通常指芯片和散热盖之间的界面材料。再在散热盖上布置TIM2,随后再安装散热器。
TIM1应用特点包括:
芯片面积较大,有时长宽可达50–100毫米。
需在叠层内部进行焊接工艺的同时,完成散热盖四周粘合剂的固化。
需根据封装的类型(PGA、LGA、BGA 等),实施精确可控的回流工艺。
焊接型导热界面材料TIM1已广泛应用于高性能计算和人工智能领域。
TIM1.5
TIM1.5指芯片与散热器之间的界面材料。它同样用于芯片级散热,但在制造流程中引入较晚,承担着连接封装与系统级冷却方案的桥梁作用。
TIM1.5应用特点包括:
理论上热传导路径更直接,界面更少,因此具备更优的散热性能。
采用较低回流焊温度或直接压合,不会对主板上已装配元件造成影响。
需要通过严格的工艺控制来适应芯片翘曲、防止焊层倾斜和减少空洞产生。
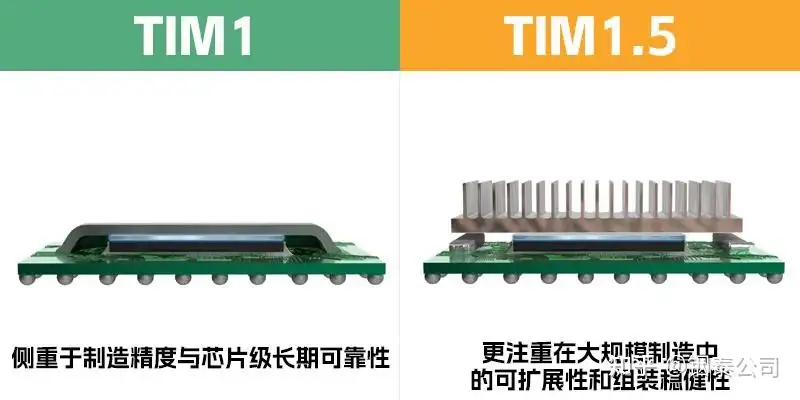
TIM1技术驱动因素
TIM1在芯片级散热中起着关键作用,其核心目标是在保证长期可靠性的前提下实现尽可能低的热阻。主要技术驱动因素包括:
降低热阻:热阻(Rth)越低,在相同功率负载下温升越小,有助于将结温控制在较低水平,从而提升器件性能。
减薄并均匀化的焊层:更薄且均匀的焊层不仅能进一步降低热阻,还可减少空洞等缺陷,避免出现类似热界面材料泵出的问题。
适应芯片高度差:随着封装内集成多个的芯片(如Chiplet),TIM1必须能够可靠地覆盖高度差异,确保所有芯片均获得良好的热接触。
此外,减少空洞也是关键因素之一。即使存在很小比例的空洞,也会阻碍热量传递并集中机械应力,进而导致器件性能下降和可靠性风险。同样重要的还包括严格控制热撕裂(固化中产生的微裂纹)和不润湿(未能充分润湿全部界面)等问题,这些缺陷会直接破坏芯片与散热盖之间关键热传导路径,影响散热效能。

TIM1.5技术驱动因素
TIM1.5的应用复杂性主要源于其对大规模组装及长期可靠性的严苛要求。主要技术驱动因素包括:
共面性控制:大型组件容易在散热盖、芯片和散热器之间产生高度差,导致焊接层厚度不均,进而引发局部过热和可靠性风险。
工艺可靠性:TIM1.5焊接区域面积较大,会放大微小缺陷的影响。因此需要稳定、一致的工艺,确保在非理想平面上实现无空洞且可靠的连接。与TIM1类似,在相同的功率负载下,更低的热阻意味着更低的温升。
可返修性:TIM1.5常用于高价值的器件。在此层级进行维修和调整更具可行性,并有助于降低废品率和整体成本。
长寿命要求:TIM1.5组件预期使用寿命可达10-15年,故障代价高昂,因此其在持续应力下的可靠性和耐久性至关重要。
此外,与TIM1应用类似,缺陷控制同样关键:必须最小化空洞、热撕裂以及不润湿等问题,这些缺陷会破坏芯片和散热器之间的热通路,影响散热性能与长期可靠性。

TIM1与TIM1.5组装工艺小结
尽管TIM1与TIM1.5在目标上各有侧重(前者注重芯片级封装精度,后者更看重系统可靠性和返修性),但两者实现均离不开精密工艺控制。
TIM1组装工艺始于晶圆制造和晶背金属化处理。在芯片切割与贴装后,将焊接型热界面材料置于芯片背面,并在散热盖周边点涂粘合剂。精确对准散热盖,并在严格受控温度曲线下加热,以形成均匀、连续的焊接层。加热(回流)曲线设定取决于芯片设计、粘合剂选型和所用焊接合金。缓慢、均匀的冷却过程有助于防止应力积聚与空洞产生。组装完成后,通常采用X射线或声学显微镜进行检测,确保界面无缺陷。
在TIM1.5工艺中,焊接面和可靠性成为首要考虑因素。在放置焊接材料前,需对基板和芯片背面进行预处理,并借助专用支撑结构在散热器对准过程中保持共面性。由于TIM1.5处于最后的回流焊接阶段,温度控制至关重要,不仅关乎到焊接界面的完整性,也直接影响主板上已有元件的安全。对于大面积焊接,采用真空或甲酸回流等新型工艺有助于促进气体的排出,减少空洞率,提升润湿性能。使用X射线检测空洞,而超声扫描会因散热器翅片结构受限。此时,整个组件已具有很高的价值,所幸TIM1.5结构中无散热盖密封胶、且所用焊接合金延展性好,通常具备可返修性。
总结
随着电子器件对功率和性能需求持续攀升,理解并把握TIM1和TIM1.5之间的关键工艺差异显得尤为重要。TIM1专注于芯片层级,提供精密的界面与超低热阻;TIM1.5则面向大面积和多芯片器件,致力于实现可靠、可返修的系统级散热解决方案。深入掌握二者特性与应用逻辑,有助于工程师们在材料选择与工艺设计做出更优决策,在应对高功率密度、高可靠性封装挑战时,提供清晰创新思路与技术实现路径。
在散热技术这一持续发展的广阔领域中,铟泰公司始终以材料科学为驱动,不断突破创新边界。我们期待与您携手,共同探索更多可能性。如果您有产品采购或试样需求,欢迎随时通过下方渠道联系我们,我们的技术专家将为您提供专属解决方案。

