降本增效再突破:铟泰公司推出无需清洗的甲酸回流焊接方案

上个月我们探讨了无助焊剂焊接技术如何助力降本增效后,许多行业伙伴对此表示浓厚兴趣,并纷纷询问:这项技术究竟依托何种产品实现?今天,我们将聚焦针对甲酸回流焊工艺特别开发的创新产品系列,深入解析其技术原理与应用优势。
电子材料创新解决方案:FAST锡膏
在电子封装领域,尤其是功率半导体模块制造中,传统锡膏依赖助焊剂实现氧化层去除与润湿保障。同时也面临三重挑战:助焊剂残留清洗工序冗余、成本高,以及潜在可靠性风险。在此背景下,甲酸回流工艺凭借“无残留、免清洗”与良好的界面润湿能力,正以颠覆性姿态重构功率电子封装技术,成为突破传统工艺瓶颈的前沿解决方案。
为最大释放甲酸工艺的技术潜力,铟泰公司创新推出FAST锡膏技术体系。该方案通过溶剂与粘结剂调配的复合配方设计,取代传统助焊剂,在回流过程中完全挥发,在确保润湿性能同时消除残留物,从而实现了工艺流程的简化。

FAST锡膏三大核心优势
1. 流程精简,降本增效
FAST锡膏在回流后无需清洗,直接减少生产环节,降低清洗剂消耗与设备投入,同时缩短工艺周期,为企业显著提升生产效率并优化成本结构。
2. 表面洁净,兼容后续工序
焊接后元件表面干净无残留,可直接进行引线键合、塑封或灌封等后续操作,避免因清洗不彻底导致的界面可靠性问题,尤其适合对洁净度要求严格的高功率器件。
3. 润湿优异,空洞率极低
复合粘结剂在合金熔化前即完全挥发,使得甲酸充分接触并清洁金属表面,促进优良的焊接润湿。同时,配方中不含易挥发性成分,从源头上减少气体产生,即便在常压回流条件下也能实现超低空洞率,若配合真空回流,效果更进一步提升。
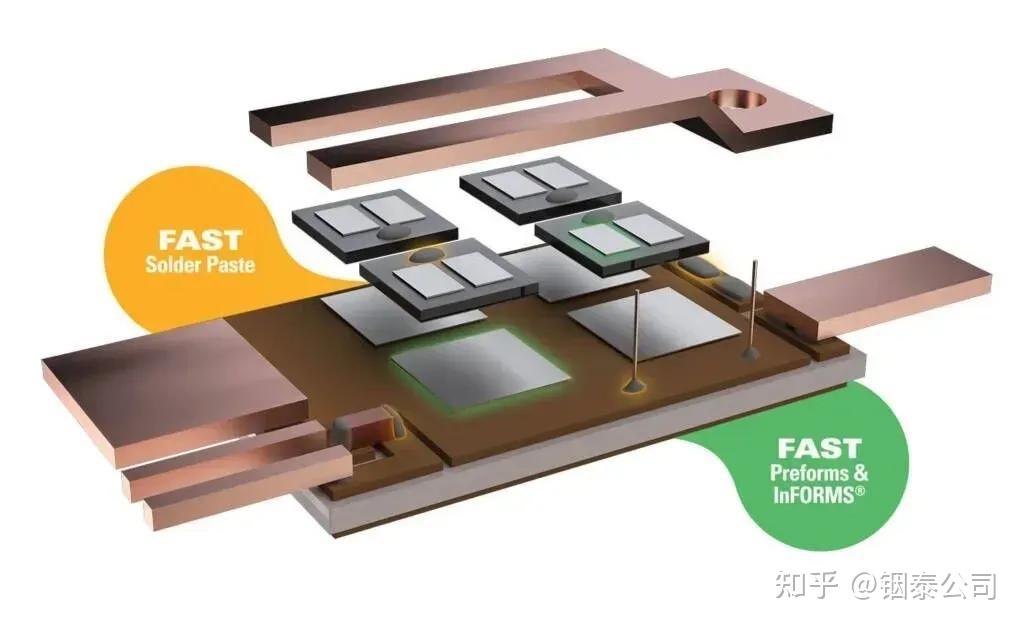
FAST锡膏专为匹配甲酸气氛回流设计,具有卓越的润湿性和可靠性、超低空洞以及广泛应用前景,同时适用于印刷与点胶工艺,灵活应对芯片粘接、引脚焊接、热敏电阻装配等多种应用场景,助力新一代电动汽车电驱模块、工业电源、光伏逆变器等高端功率电子设备的可靠制造。
不止于锡膏:铟泰公司的全套解决方案
FAST锡膏只是我们在无焊剂焊接领域中的一环。我们还提供预成型焊片、InTACK™临时粘合剂,定制化高可靠性合金等系列产品,并配备从工艺调试、性能测试到资格认证的全流程技术支持,帮助客户顺利完成技术导入与量产升级。

关于价格、技术或工艺的任何问题,都欢迎您通过以下方式联系我们!

